Transistors à Effet de Champ et Uni-Jonction :
Dans cette leçon des semi-conducteurs, nous examinerons les transistors à EFFET DE CHAMP et UNI-JONCTION.
![]() 1. - TRANSISTORS À EFFET DE CHAMP
1. - TRANSISTORS À EFFET DE CHAMP
Les transistors à EFFET DE CHAMP, sont désignés par l'abréviation anglo-saxonne F.E.T. (Fild Effect transistor).
Les transistors F.E.T. diffèrent complètement des types étudiés jusqu'ici, à tel point que même les électrodes ont une appellation spéciale. En effet, lorsqu'il s'agit d'un transistor normal, l'émetteur correspond à l'électrode à partir de laquelle part le flux de charge (électrons ou trous), le collecteur l'électrode recueillant ce flux et la BASE l'électrode permettant de contrôler celui-ci.
Dans un transistor F.E.T. l'électrode à partir de laquelle le flux de charge est émis s'appelle SOURCE, l'électrode recevant ce flux est appelée DRAIN et enfin, l'électrode permettant le contrôle du flux est appelée PORTE.
La figure 1 représente la structure schématique d'un transistor F.E.T.
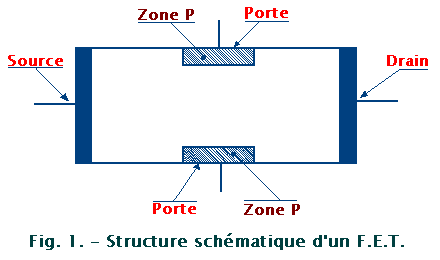
Ce dispositif est constitué par un bloc de silicium dans lequel on a introduit des impuretés, de façon à obtenir un semi-conducteur du type N.
On applique aux extrémités de ce bloc deux plaques conductrices, dont l'une représente la SOURCE et l'autre le DRAIN.
Sur les côtés du bloc, on forme ensuite deux zones de type P, constituant la PORTE (figure 1). Ainsi, entre ces deux zones de type P, un canal de type N s'étend de la SOURCE au DRAIN.
Le bloc comprend ainsi deux jonctions P.N.
Supposons que l'on applique une tension entre la SOURCE et le DRAIN, au moyen d'une batterie reliée entre ces deux électrodes (figure 2).
La porte reste libre pour l'instant.

Dans ces conditions, le bloc de silicium se comporte comme on l'a vu précédemment en traitant les problèmes de conduction dans un semi-conducteur de type N.
Les PORTEURS MAJORITAIRES (électrons), passent de la SOURCE (négative) au DRAIN (positif), créant dans le circuit extérieur un COURANT D'ABSORPTION qui selon le sens conventionnel, se trouve dirigé dans le sens de la flèche montrée figure 2.
L'intensité de ce courant dépend de la résistance que les électrons rencontrent le long du canal, allant de la SOURCE au DRAIN. Ainsi, en diminuant la largeur du canal on a une augmentation de résistance étant donné que la section est plus réduite.
Il est possible, électriquement, de réduire le courant c'est-à-dire d'augmenter la résistance du canal, en POLARISANT LA PORTE DANS LE SENS INVERSE, par rapport à la SOURCE. A cet effet, il suffit de relier une batterie entre les deux zones P, comme indiqué figure 3.
On remarque que les deux zones de type P constituant la porte, sont reliées directement entre elles et connectées au négatif de la batterie B1. Le positif de cette même batterie est relié à la SOURCE (figure 3).
Sous l'effet de la polarisation inverse, il se forme à proximité des jonctions une zone privée de charges libres, DONC UNE ZONE OU LE COURANT NE PEUT CIRCULER. La figure 3 illustre ce phénomène. En effet, le rétrécissement du canal entraîne une augmentation de la résistance, augmentation ayant pour conséquence de réduire l'INTENSITÉ DU COURANT D'ABSORPTION.
Comme l'amplitude des zones privées de charges libres dépend de la valeur de la tension de polarisation de la PORTE, on comprend que LORSQUE CETTE TENSION VARIE, L'INTENSITÉ DU COURANT D'ABSORPTION VARIE ÉGALEMENT.
Il est même possible, en augmentant la tension de polarisation inverse, de BLOQUER COMPLÈTEMENT LE CANAL, c'est-à-dire d'interrompre totalement la circulation du courant d'absorption.
La valeur de la tension pour laquelle se produit ce phénomène est appelée TENSION D'INTERDICTION. Ainsi, les transistors F.E.T. permettent de contrôler un courant au moyen d'une tension. Ce contrôle de courant ne nécessite aucune dépense de puissance. En effet, la tension de contrôle étant appliquée entre la PORTE et la SOURCE, (de façon à polariser en sens inverse la jonction située entre les deux zones P et la zone N) ne donne lieu qu'au seul passage du COURANT INVERSE, très faible.
De cette façon, la RÉSISTANCE D'ENTRÉE des transistors F.E.T. atteint des valeurs de l'ordre de 10 000 MW, valeurs beaucoup plus élevées que celles des transistors courants. Ainsi, les F.E.T. unissent donc aux propriétés des transistors ordinaires, l'avantage d'avoir une résistance élevée.
Pour ces composants, il est évidemment possible de relever les courbes caractéristiques, parmi lesquelles la famille des caractéristiques d'absorption, ayant pour paramètre la tension VPS (tension appliquée entre la PORTE et la SOURCE) nous intéresse particulièrement.
Appliquons une tension VPS de valeur déterminée entre la PORTE et la SOURCE et faisons varier la tension V.A.S. (tension présente entre le drain et la source) et pour chaque valeur de celle-ci, mesurons le courant d'absorption IA.
On trouve ainsi les données nécessaires pour tracer sur un diagramme Cartésien, une première caractéristique d'absorption. Il est également possible d'obtenir d'autres caractéristiques en donnant diverses valeurs à la tension VPS et en trouvant pour chacune d'elles les valeurs prises par le courant IA, lorsque la tension V.A.S. varie.
La figure 4 donne un exemple d'une famille de caractéristiques de courant d'absorption.

On remarque plus particulièrement qu'à partir d'un certain point, le courant d'absorption IA n'augmente plus sensiblement, même si la tension VAS continue à croître.
Afin de mieux comprendre le motif de ce comportement, reportons-nous à la figure 3.
On remarque en effet que les zones privées de charges libres, n'ont pas une extension constante le long de la PORTE, mais par contre, celles-ci sont beaucoup plus larges du côté du DRAIN.
Cette répartition des zones est due au fait que la tension présente entre la PORTE et la SOURCE, augmente à mesure qu'elle s'approche du DRAIN, en raison de la chute de tension se produisant le long du canal, sous l'effet du courant circulant de la SOURCE au DRAIN.
Or, comme nous l'avons vu, l'augmentation de cette zone réduit le canal c'est-à-dire augmente la résistance, ce qui réduit le courant.
On comprend ainsi que le courant d'absorption ne puisse augmenter indéfiniment, car à partir d'une certaine valeur, son accroissement détermine un rétrécissement du canal, limitant l'intensité de ce courant.
La structure du F.E.T. montrée figure 3 est essentiellement schématique. En effet, son but est de visualiser le principe de fonctionnement de cet élément.
La conception exacte du transistor F.E.T. est donnée figure 5.

La plaquette du type P, sur laquelle ont été effectuées les différentes opérations, constitue les zones P de la porte. Ces dernières, ainsi que la zone N situé entre les portes, sont pourvues d'électrodes métalliques destinées au branchement du composant.
Jusqu'ici, nous n'avons considéré que les F.E.T. constitués par un canal de type N situé entre deux zones de type P.
Pour ceux-ci, le courant circulant entre la SOURCE et le DRAIN est constitué d'électrons. Cependant, on fabrique également des F.E.T. à canal P, dont la porte est constituée de deux zones N.
Le courant est alors formé de TROUS. Le fonctionnement ne diffère en rien de celui des F.E.T. à canal N. Bien entendu, le F.E.T. à canal P, nécessite des tensions de polarités inverses par rapport à celles du F.E.T. à canal N.
Il est encore possible d'augmenter la valeur de la résistance d'entrée en réalisant des transistors dont la structure et le fonctionnement diffèrent du F.E.T. à jonctions.
Ce nouveau type de transistor désigné par l'abréviation MOS F.E.T. présente la particularité d'avoir la PORTE ISOLÉE par rapport au canal.
L'abréviation MOS F.E.T. provient des termes anglo-saxons "Métall Oxide Semi-conductor, Fild Effect Transistor" signifiant Transistor à Effet de Champ, Métal Oxyde Semi-conducteur.
Les trois derniers mots indiquent la structure particulière de ce transistor que nous allons décrire.
Le MOS F.E.T. (montré figure 6) est réalisé sur une plaquette de silicium de type P, sur un côté de laquelle on forme par diffusion des zones de type N à fort dopage.
Sur ce même côté, on dépose une très fine couche isolante de BIOXYDE DE SILICIUM, obtenue par évaporation. Cette couche isolante ne couvre pas toute la surface, car au moment de la déposition du bioxyde, on laisse les deux zones N découvertes, de façon à pouvoir y disposer les électrodes métalliques, dont l'une constituée la SOURCE et l'autre le DRAIN. Enfin, sur la surface de la couche de bioxyde de silicium comprise entre les deux zones P, on ajoute une couche d'aluminium, constituant la PORTE.
Celle-ci se trouve évidemment isolée par rapport à la substance semi-conductrice, au moyen de la couche de bioxyde interposée.
Les trois mots "métal, oxyde, semi-conducteur" dont nous avons parlé, indiquent précisément la succession des divers éléments correspondant à la PORTE. En effet, en se reportant à la figure 6, on rencontre de haut en bas :
-
l'aluminium (métal)
-
le bioxyde (oxyde)
-
le silicium (semi-conducteur)
Le fonctionnement du MOS F.E.T. est le suivant :
En appliquant une tension entre la PORTE et la SOURCE, de façon à rendre la première positive par rapport à la seconde, la PORTE se trouve positive par rapport à la plaquette de silicium P.
Par conséquent, les charges mobiles positives de silicium P sont repoussées vers l'intérieur de la plaquette, alors que les charges mobiles négatives de la source sont attirées en surface.
Plus précisément, sur la surface de la plaquette relative à la couche de bioxyde de silicium située sous la porte, il se forme une couche de charges mobiles négatives, établissant une liaison entre la SOURCE et le DRAIN et formant un canal N, comme le montre la figure 6.
Ce canal présente une certaine résistance, que l'on peut réduire en augmentant la tension appliquée à la porte. Sous l'effet de la tension, le nombre des électrons présents dans le canal augmente.
D'autre part, en appliquant une tension adéquate entre le DRAIN et la SOURCE, on obtient un courant d'absorption, dû aux électrons du canal reliant les deux électrodes.
On peut faire varier l'intensité de ce courant, en modifiant la valeur de la tension appliquée entre la PORTE et la SOURCE. Bien que la PORTE soit maintenant positive par rapport à la SOURCE, elle n'est parcourue par aucun courant étant donné que la couche de bioxyde de silicium l'isole totalement du canal. Par conséquent, la RÉSISTANCE D'ENTRÉE DU MOS F.E.T. atteint des valeurs de l'ordre du MILLIARD DE MÉGOHMS.
En fait, la porte et la plaquette du semi-conducteur du MOS F.E.T., étant réciproquement isolées au moyen de la couche de bioxyde de silicium, se comportent comme les deux armatures d'un condensateur.
La tension de contrôle crée un champ électrique entre ces deux électrodes, champ ayant une influence sur le nombre des électrons présents dans le canal. Ainsi, il est possible de contrôler le courant d'absorption.
Les transistors du type que nous venons d'étudier sont dits à "effet de champ" précisément par le fait que le contrôle du courant d'absorption, s'effectue en utilisant l'effet produit par un champ électrique.
Dans les transistors ordinaires par contre, le contrôle du courant de collecteur est obtenu à l'aide d'un autre courant.
Les F.E.T. MOS peuvent fonctionner de deux façons différentes : soit par ENRICHISSEMENT soit par RAREFACTION, suivant le type de construction adopté.
Lorsque le MOS F.E.T. est constitué par un canal N, situé entre deux zones de type N fortement dopées, alors que la PORTE s'étend le long du canal tout entier (figure 6), le fonctionnement se fait par ENRICHISSEMENT. En effet, en rendant la PORTE positive par rapport à la SOURCE, on enrichit le canal d'électrons, réduisant ainsi la résistance entre la SOURCE et le DRAIN.
Dans ce cas, si la tension appliquée à la porte est nulle, le nombre des électrons présents dans le canal est très petit et le courant d'absorption pratiquement nul.
Les MOS F.E.T. fonctionnant par enrichissement présentent un inconvénient : capacité très importante entre la PORTE et plaquette du semi-conducteur. Cette capacité peut être réduite, en utilisant une porte qui ne couvre qu'une partie du canal (figure 7).
Cette solution présente toutefois l'inconvénient de provoquer une très haute résistance dans la partie du canal n'étant pas enrichie d'électrons.
On remédie à cet inconvénient par un dopage adéquat, permettant d'obtenir un canal de basse résistance, même lorsque la tension appliquée à la porte est nulle.

On arrive ainsi à un MOS F.E.T., dont le CANAL, la SOURCE et le DRAIN sont constitués par le même matériau de type N (la SOURCE et le DRAIN étant cependant plus fortement dopés) et dont le fonctionnement s'effectue par RARÉFACTION. Dans ce cas, en appliquant à la PORTE une tension négative, celle-ci repousse les électrons du canal, produisant une zone de raréfaction des charges (figure 7).
Par conséquent, le courant d'absorption s'annule uniquement lorsque la tension négative appliquée à la porte atteint une valeur suffisante pour déterminer le "blocage" du canal.
Les caractéristiques du courant d'absorption d'un MOS F.E.T. du type à enrichissement, diffèrent de celles d'un MOS F.E.T. à raréfaction, surtout en ce qui concerne les valeurs de la tension appliquée entre la PORTE et la SOURCE.
La figure 8 met en évidence la diffèrence qui caractérise ces deux types.
Dans le cas du type à enrichissement (figure 8-a), les tensions VPS ont des valeurs exclusivement positives, comprises entre 8 et 20 volts.
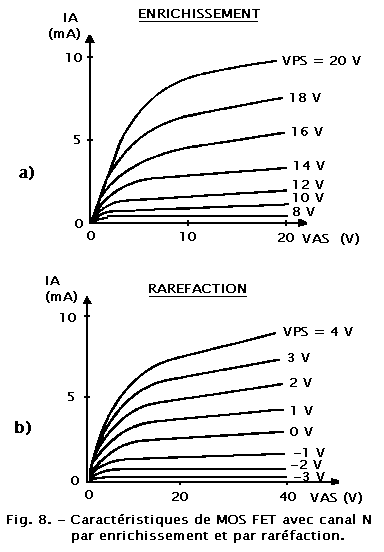
Pour le type à raréfaction (figure 8-b), ces mêmes tensions sont négatives ou positives et comprises entre - 3 V et + 4 V.
Soulignons que les MOS F.E.T. peuvent être réalisés avec un canal P. Dans ce cas, les observations faites précédemment au sujet du F.E.T. à jonction restent valables.
![]() 2. - TRANSISTOR UNI-JONCTION
2. - TRANSISTOR UNI-JONCTION
Le transistor UNI-JONCTION doit son nom au fait qu'il ne comporte qu'une seule jonction. Ce type de transistor est souvent repéré par le sigle U.J.T. de l'anglais "Uni-Jonction Transistor".
Cette propriété permet des emplois particuliers, parmi lesquels on peut citer les générateurs d'impulsions, nécessaire à la commande des thyristors (transistors de commutation dont nous étudierons les caractéristiques dans la prochaine leçon "Semi-conducteurs 8").
Pour comprendre le fonctionnement d'un transistor UNI-JONCTION, il faut examiner sa structure en se reportant à la figure 9-a. La figure 9-b représente le symbole schématique adopté pour la représentation de l'U.J.T.
Ce composant est principalement constitué d'une BARRETTE DE SILICIUM N, aux extrémités de laquelle sont disposés deux contacts, appelés "première base (B1) et deuxième base (B2)". Ces contacts sont du type purement ohmique, c'est-à-dire qu'entre eux et la barrette de silicium, il N'EXISTE AUCUNE JONCTION.

L'unique jonction P.N. se trouve entre la barrette et l'électrode E, correspondant à l'émetteur. Cette électrode se trouve placée plus près de la deuxième base que la première, comme on peut le voir sur la figure 9-a.
La barrette de silicium N, possède les caractéristiques normales d'une résistance et sa valeur est comprise entre 5 W et 10 kW.
On applique une tension VBB entre les deux bases, de façon à rendre la seconde positive par rapport à la première. Sous l'effet de cette tension, la BARRETTE DE SILICIUM N est parcourue par un courant, constitué d'électrons, se dirigeant de la première base vers la seconde.
Sous l'effet de cette résistance présentée par la barrette, le courant produit une chute de tension dans celui-ci.
Pour bien voir comment s'effectue la répartition de la tension le long de la barrette, on représente le transistor comme indiqué figure 10.

Au moyen des résistances R1 et R2, on insère la résistance du silicium entre la première base et l'émetteur et entre ce dernier et la SECONDE BASE.
Sur la figure 10, on indique par V1 la chute de tension aux bornes de R1 (tension présente sur la cathode de la diode).
En appliquant sur l'anode, une tension VE inférieure à V1, la diode est polarisée dans le sens inverse et le courant ne peut circuler. Par contre, si VE a une valeur supérieure à V1, la diode est polarisée dans le sens direct ; dans ce cas, un courant d'émetteur IE circule dans le sens indiqué figure 10.
CE COURANT EST ESSENTIELLEMENT CONSTITUÉ DE TROUS SE DIRIGEANT DE LA BARRETTE VERS LA PREMIÈRE BASE.
Ces trous sont l'équivalent des électrons présents dans la zone comprise entre l'émetteur et la première base, zone où se produit une augmentation du nombre des porteurs. Cela signifie que la résistance de cette zone est réduite et par conséquent elle peut être traversée par un courant plus élevé, en provenance de l'émetteur.
Or, un courant d'émetteur plus intense, introduit un plus grand nombre de porteurs et provoque une nouvelle diminution de la résistance. Il en résulte un courant encore plus intense, donc une nouvelle diminution de la résistance et ainsi de suite.
On peut penser que le courant augmente jusqu'à atteindre des valeurs extrêmement élevées ; or, il n'en est rien car en même temps que le courant augmente, la tension d'émetteur diminue. Ce fait est facilement contrôlable en relevant les caractéristiques, indiquant comment varie la tension d'émetteur VE, en fonction du courant IE.
Ces caractéristiques sont représentées figure 11. Chacune d'elles se réfère à une valeur particulière de la tension VBB.
Considérons par exemple la courbe relative à VBB = 15 V.

Pour une valeur nulle du courant IE, la courbe présente un trait vertical, correspondant au moment où la jonction entre l'émetteur et la barrette de silicium est polarisée inversement.
Lorsque la tension VE atteint une valeur d'environ 10 V, cette même jonction se trouve polarisée dans le sens direct et par conséquent, le courant d'émetteur commence à circuler. A mesure que ce courant augmente d'intensité, la tension VE diminue et se rapproche de l'axe horizontal.
Lorsqu'un élément se comporte de cette façon, on dit qu'il présente une résistance négative.
Cette propriété est très utile pour la réalisation de nombreux circuits, capables d'engendrer des formes d'ondes particulières. En effet, ce type de transistor se comporte comme un interrupteur qui, selon la valeur de la tension appliquée à l'émetteur, se trouve OUVERT (haute impédance d'entrée) ou FERME (basse impédance d'entrée).
Nous constatons donc que le transistor UNI-JONCTION a des applications diffèrentes de celles des transistors étudiés précédemment.
Nous terminons ici la technologie des transistors. Dans la prochaine leçons, nous aborderons l'étude des THYRISTOR, du DIAC et du TRIAC et enfin, nous commencerons les leçons d'électroniques digitales.
 Cliquez ici pour la leçon suivante ou dans le sommaire prévu à cet effet. Cliquez ici pour la leçon suivante ou dans le sommaire prévu à cet effet. |
|
 Page précédente Page précédente
|
 Page suivante Page suivante
|
Nombre de pages vues, à partir de cette date : le 23 MAI 2019
Envoyez un courrier électronique à Administrateur Web Société pour toute question ou remarque concernant ce site Web.
Version du site : 10. 5. 14 - Site optimisation 1280 x 1024 pixels - Faculté de Nanterre - Dernière modification : 22 MAI 2023.
Ce site Web a été Créé le, 14 Mars 1999 et ayant Rénové, en MAI 2023.
 Transistors à Effet de Champ
Transistors à Effet de Champ